MOSFET
作者:刘松
1、功率MOSFET选型第一步:P管,还是N管?
功率MOSFET有二种类型:N沟道和P沟道,在系统设计的过程中选择N管还是P管,要针对实际的应用具体来选择,N沟道MOSFET选择的型号多,成本低;P沟道MOSFET选择的型号较少,成本高。如果功率MOSFET的S极连接端的电压不是系统的参考地,N沟道就需要浮地供电电源驱动、变压器驱动或自举驱动,驱动电路复杂;P沟道可以直接驱动,驱动简单。
需要考虑N沟道和P沟道的应用主要有:
(1)笔记本电脑、台式机和服务器等使用的给CPU和系统散热的风扇,打印机进纸系统电机驱动,吸尘器、空气净化器、电风扇等白家电的电机控制电路,这些系统使用全桥电路结构,每个桥臂上管可以使用P管,也可以使用N管。
(2)通讯系统48V输入系统的热插拨MOSFET放在高端,可以使用P管,也可以使用N管。
(3)笔记本电脑输入回路串联的、起防反接和负载开关作用的二个背靠背的功率MOSFET,使用N沟道需要控制芯片内部集成驱动的充电泵,使用P沟道可以直接驱动。
2、选取封装类型
功率MOSFET的沟道类型确定后,第二步就要确定封装,封装选取原则有:
(1)温升和热设计是选取封装最基本的要求
不同的封装尺寸具有不同的热阻和耗散功率,除了考虑系统的散热条件和环境温度,如是否有风冷、散热器的形状和大小限制、环境是否封闭等因素,基本原则就是在保证功率MOSFET的温升和系统效率的前提下,选取参数和封装更通用的功率MOSFET。
有时候由于其它条件的限制,需要使用多个MOSFET并联的方式来解决散热的问题,如在PFC应用、电动汽车电机控制器、通讯系统的模块电源次级同步整流等应用中,都会选取多管并联的方式。
如果不能采用多管并联,除了选取性能更优异的功率MOSFET,另外可以采用更大尺寸的封装或新型封装,比如在一些ACDC电源中将TO220改成TO247封装;在一些通讯系统的电源中,采用DFN8*8的新型封装。
(2)系统的尺寸限制
有些电子系统受制于PCB的尺寸和内部的高度,如通讯系统的模块电源由于高度的限制通常采用DFN5*6、DFN3*3的封装;在有些ACDC的电源中,使用超薄设计或由于外壳的限制,装配时TO220封装的功率MOSFET管脚直接插到根部,高度的限制不能使用TO247的封装。有些超薄设计直接将器件管脚折弯平放,这种设计生产工序会变复杂。
在大容量的锂电池保护板的设计中,由于尺寸限制极为苛刻,现在大多使用芯片级的CSP封装,尽可能的提高散热性能,同时保证最小的尺寸。
(3)公司的生产工艺
TO220有二种封装:裸露金属的封装和全塑封装,裸露金属的封装热阻小,散热能力强,但在生产过程中,需要加绝缘坠,生产工艺复杂成本高,而全塑封装热阻大,散热能力弱,但生产工艺简单。
为了减小锁螺丝的人工工序,近几年一些电子系统采用夹子将功率MOSFET夹在散热片中,这样就出现了将传统的TO220上部带孔的部分去除的新的封装形式,同时也减小的器件的高度。
(4)成本控制
早期很多电子系统使用插件封装,这几年由于人工成本增加,很多公司开始改用贴片封装,虽然贴片的焊接成本比插件高,但是贴片焊接的自动化程度高,总体成本仍然可以控制在合理的范围。在台式机主板、板卡等一些对成本极其敏感的应用中,通常采用DPAK封装的功率MOSFET,因为这种封装的成本低。
因此在选择功率MOSFET的封装时,要结合自己公司的风格和产品的特点,综合考虑上面因素。
3、选取耐压BVDSS
在大多数情况下,似乎选取功率MOSFET的耐压对于很多工程师来说是最容易的一件事情,因为设计的电子系统输入电压是相对固定的,公司选取特定的供应商的一些料号,产品额定电压也是固定的。比如在笔记本电脑适配器、手机充电器中,输入为90-265V的交流,初级通常选用600V或650V的功率MOSFET;笔记本电脑主板输入电压19V,通常选用30V的功率MOSFET,根本不需要任何的考虑。
数据表中功率MOSFET的击穿电压BVDSS有确定的测试条件,在不同的条件下具有不同的值,而且BVDSS具有正温度系数,在实际的应用中要结合这些因素综合考虑。
很多资料和文献中经常提到:如果系统中功率MOSFET的VDS的最高尖峰电压如果大于BVDSS,即便这个尖峰脉冲电压的持续只有几个或几十个nS,功率MOSFET也会进入雪崩从而发生损坏。
不同于三极管和IGBT,功率MOSFET具有抗雪崩的能力,而且很多大的半导体公司功率MOSFET的雪崩能量在生产线上是全检的、100%检测,也就是在数据中这是一个可以保证的测量值,雪崩电压通常发生在1.2-1.3倍的BVDSS,而且持续的时间通常都是uS、甚至mS级,那么持续只有几个或几十个nS、远低于雪崩电压的尖峰脉冲电压是不会对功率MOSFET产生损坏的。
为什么在实际的设计中,要求在最极端的情况下,功率MOSFET的最大VDS电压必须低于BVDSS、同时还要有一定的降额,如5%,10%,甚至20%的降额?
原因在于:保证电子系统的可生产性,以及在大批量生产时候的可靠性。
任何电子系统的设计,实际的参数都会有一定的变化范围,有时候很难保证多个极端的情况碰到一起,从而对系统产生问题,特别是在高温的条件下,功率器件以及系统的其它元件温度系数的漂移会产生一些难以想象的问题,降额以及设计的裕量可以尽可能的减小在这些极端条件下发生损坏的问题。
4、由驱动电压选取VTH
不同电子系统的功率MOSFET选取的驱动电压并不相同,ACDCD电源通常使用12V的驱动电压,笔记本的主板DCDC变换器使用5V的驱动电压,因此要根据系统的驱动电压选取不同阈值电压VTH的功率MOSFET。
数据表中功率MOSFET的阈值电压VTH也有确定的测试条件,在不同的条件下具有不同的值,VTH具有负温度系数。不同的驱动电压VGS对应着不同的导通电阻,在实际的应用中要考虑温度的变化,既要保证功率MOSFET完全开通,同时又要保证在关断的过程中耦合在G极上的尖峰脉冲不会发生误触发产生直通或短路。
5、选取导通电阻RDSON,注意:不是电流
很多时候工程师关心RDSON,是因为RDSON和导通损耗直接相关,RDSON越小,功率MOSFET的导通损耗越小、效率越高、温升越低。同样的,工程师尽可能沿用以前项目中或物料库中现有的元件,对于RDSON的真正的选取方法并没有太多的考虑。当选用的功率MOSFET的温升太低,出于成本的考虑,会改用RDSON大一些的元件;当功率MOSFET的温升太高、系统的效率偏低,就会改用RDSON小一些的元件,或通过优化外部的驱动电路,改进散热的方式等来进行调整。
想一想:如果是一个全新的项目,没有以前的项目可循,那么如何选取功率MOSFET的RDSON?
这里作者介绍一个方法给大家:功耗分配法。
当设计一个电源系统的时候,已知条件有:输入电压范围,输出电压/输出电流,效率,工作频率,驱动电压,当然还有其它的技术指标,和功率MOSFET相关的主要是这些参数。
步骤如下:
(1)根据输入电压范围,输出电压/输出电流,效率,计算系统的最大损耗。
(2)功率回路的杂散损耗,非功率回路元件的静态损耗,IC的静态损耗以及驱动损耗,做大致的估算,经验值可以占总损耗的10%-15%。如果功率回路有电流取样电阻,计算电流取样电阻的功耗。总损耗减去上面的这些损耗,剩下部分就是功率器件、变压器或电感的功率损耗。
将剩下的功率损耗按一定的比例分配到功率器件和变压器或电感中,不确定的话,按元件数目平均分配,这样就得到每个MOSFET的功率损耗。
(3)将MOSFET的功率损耗,按一定的比例分配给开关损耗和导通损耗,不确定的话,平均分配开关损耗和导通损耗。
(4)由MOSFET导通损耗和流过的有效值电流,计算最大允许的导通电阻,这个电阻是MOSFET在最高工作结温的RDSON。
数据表中功率MOSFET的RDSON标注有确定的测试条件,在不同的定义的条件下具有不同的值,测试的温度为:TJ=25℃,RDSON具有正温度系数,因此根据MOSFET最高的工作结温和RDSON温度系数,由上述RDSON计算值,得到25℃温度下对应的RDSON。
(5)由25℃的RDSON来选取型号合适的功率MOSFET,根据MOSFET的RDSON实际参数,向下或向上修整。
通过以上步骤,就初步选定功率MOSFET的型号和RDSON参数。
很多资料和文献中,经常计算系统的最大电流,然后进行降额,由功率MOSFET数据表的电流值来选取器件,这种方法是不对的。
功率MOSFET的电流是一个计算值,而且是基于TC=25℃,也没有考虑开关损耗,因此这种方法和实际的应用差距太大,没有参考价值。在一些有大电流冲击要求有短路保护的应用中,会校核数据表中的最大漏极脉冲电流值及其持续时间,这个和选取RDSON没有直接的关系。
6、选取开关特性:Crss、Coss、Ciss;Qg、Qgd、Qoss
功率MOSFET在开关过程中产生开关损耗,开关损耗主要和这些开关特性参数有关。QG影响驱动损耗,这一部分损耗并不消耗在功率MOSFET中,而且是消耗在驱动IC中。QG越大,驱动损耗越大。
基于RDSON选取了功率MOSFET的型号后,这些开关特性参数都可以在数据表中查到,然后根据这些参数计算开关损耗。
7、热设计及校核
根据选取的功率MOSFET的数据表和系统的工作状态,计算其导通损耗和开关损耗,由总的功率损耗和工作的环境温度计算MOSFET的最高结温,校核其是否在设计的范围。所有条件基于最恶劣的条件,然后由计算的结果做相应的调整。
如果总的损耗偏大,大于分配的功率损耗,那么就要重新选取其它型号的功率MOSFET,可以查看比选取的功率MOSFE的RDSON更大或更小的其它型号,再次校核总的功率损耗,上述过程通常要配合第5、6步,经过几次的反复校验,最后确定与设计相匹配的型号,直到满足设计的要求。
有时候由于产品型号的限制找不到参数合适的产品,可以采用以下的方法:
(1)使用多管并联的方式,来解决散热和温升的问题。
(2)将功率损耗重新分配,变压器或电感、其它的功率元件分配更多的功耗。更改功率分配的时候,也要保证其它元件的温升满足系统设计要求。
(3)如果系统允许,改变散热的方式或加大散热器的尺寸。
(4)其它因素,调整工作频率、更改电路结构等,如PFC采用交错结构,采用LLC或其它软开关电路。
8、校核二极管特性
在桥式电路中如全桥、半桥、LLC以及BUCK电路的下管,有内部寄生二极管的反向恢复的问题,最简单的方法就是采用内部带快恢复二极管的功率MOSFET,如果内部不带快恢复二极管,就要考虑内部寄生二极管的反向恢复特性:Irrm、Qrr、trr、trr1/trr2,如trr要小于250nS,这些参数影响着关断的电压尖峰、效率,以及可靠性,如在LLC的起动、短路中,系统进入容性模式、若二极管反向恢复性能较差,容易产生上下管直通而损坏的问题。如果控制器具有容性模式保护功能,就不用考虑这个因素。
9、雪崩能量及UIS、dv/dt
雪崩能量及测试的条件参考下面的文章,有非常详细的详明。除了反激和一些电机驱动的应用,大多结构不会发生这种单纯的电压箝位的雪崩,很多应用情况下,二极管反向恢复过程中dv/dt、过温以及大电流的综合作用产生动态雪崩击穿损坏。
10、其它参数
内部RG的大小、负载开关和热插拨工作在线性区的问题、SOA特性,和EMI相关的参数、等等。
本文转自:松哥电源(adlsong2016),作者:刘松,转载此文目的在于传递更多信息,版权归原作者所有。
日前,Vishay Intertechnology, Inc.(NYSE 股市代号:VSH)宣布,将在3月17日-21日于加利福尼亚州阿纳海姆(Anaheim,California)举行的2019年国际应用电力电子展会(APEC)上展示其强大产品阵容。Vishay展位设在411展台,将展示适用于广泛应用领域的最新业内领先功率IC、无源器件、二极管和MOSFET技术。
在APEC 2019上展示的Vishay Siliconix电源IC包括SiC9xx microBRICKÔ系列高效率DC/DC升压稳压器。这款业内占位面积最小的器件采用集成磁芯,结合可靠设计与易用性为通信、工业和服务器应用提供高性价比解决方案。同时,展示80 A SiC8xx VRPower® 智能功率级。利用Vishay最新25 V和30 V trench MOSFET,器件峰值效率达95 %,精度高达± 3 %。
展出的Vishay Siliconix功率MOSFET采用各种先进封装,显著提升电源效率和功率密度。器件展品包括第四代600V E系列功率MOSFET,该系列器件极低的导通阻抗从23 mW 到1450 mW,用于功率因数校正(PFC)和硬开关DC/DC转换器拓扑,可实现业内最优品质因素FOM(即栅级电荷与导通电阻乘积)。在工业电机驱动控制、小型太阳能逆变器和可穿戴设备方面,展出的低压TrenchFET® 第四代器件导通电阻低至0.58 mW,具有业内最低QOSS与导通电阻乘积FOM。
展出的Vishay Semiconductors二极管包括用于PFC和输出整流级的新型FRED Pt® 第五代 1200 V Hyperfast和Ultrafast整流器。30 A和60 A整流器导通和开关损耗在同类器件中达到最佳水平,效率相比硅片产品提高15 %。同时还将展出采用SlimDPAK(TO-252AE)封装的TMBS® 器件,具有ESD功能、采用超薄SMPA(DO-221BC)封装的标准恢复整流器,额定电流达2 A、采用MicroSMP(DO-219AD)封装的FRED Pt®超快恢复整流器。模块展品包括SOT-227封装650 V超快恢复单相整流桥和1200 V标准双模器件,四种可选封装、通过AEC-Q101认证的高压晶闸管和二极管。
无源元件展品包括各种Vishay电容器、电阻器和电感器。Vishay BCcomponents将展示新款微型牛角式和螺丝接头铝电容器,以及X1、X2和Y2 EMI静噪薄膜电容器,这些器件均通过IEC 60384-14: 2013 / AMD1: 2016 IIIB级认证,此外,还将展示满足双85,1000小时测试要求的陶瓷安规电容器,ENYCAPÔ电双层储能电容器。陶瓷盘式电容器展品包括额定电压50 kVDC (34 kVRMS)新型Vishay Cera-Mite螺丝固定电容器,以及额定电压15 kV,业内2 nF高容量小型径向引线Vishay Roederstein电容器。Vishay Roederstein还将展出AC滤波和DC-Link金属化聚丙烯膜电容器。运输、工业和替代能源应用方面,Vishay ESTA将展示水冷式感应加热电容器、电力电子器件、三相组件和采用ESTAspring,业内首款杠杆操作弹簧接头连接的 LVAC功率电容器。
电阻器展品包括新型Vishay BCcomponents VDR金属氧化物压敏电阻(MOV),工作温度达+125 °C,抗浪涌电流能力达13 kA。厚膜器件包括Vishay Techno高压和中压片式电阻分压器、防脉冲Vishay Draloric电阻器、通过AEC-Q200认证的Vishay Sfernice器件、Vishay MCB功率电阻器和Vishay Dale氮化铝器件。薄膜电阻器包括Vishay Dale大功率片式电阻,以及Vishay Beyschlag / Draloric通过AEC-Q200认证的片式和MELF电阻。此外,Vishay Draloric将展示可熔断绕线安规电阻及小型铝壳电阻,同时Vishay Milwaukee展示动态制动和中性点接地电阻,Vishay MCB展示功率达9000 W的水冷电阻。Vishay BCcomponents将展出用于温度检测、通过AEC-Q200认证的NTC接线片传感器和热敏电阻裸片,以及用于能量甩负荷的PTCEL电源浪涌限流器。
Vishay Dale超薄、大电流电感器产品线展品包括工作温度达+180 °C,九种外形尺寸和18种不同高度的汽车级IHLP®系列电感器;带有集成式电场遮罩,能够减小EMI的IHLE系列电感器;以及采用铁粉芯技术,具有稳定饱和性能的IHDM系列功率电感器。展示的Vishay Custom Magnetics解决方案包括平面封装新款小型栅级驱动变压器,总线驱动电压达1200 V,以及高功率密度、封装高度仅为16.5 mm的混合式平面变压器。
Vishay还将在展台上提供多种产品演示,包括Vishay Techno CDMM厚膜表面贴装片式电阻分压器;Vishay Beyschlag MELF电阻器;Vishay Dale RCP厚膜和PCAN薄膜大功率、表面贴装片式电阻器;Vishay BCcomponents 196 HVC ENYCAPÔ 混合储能电容器;Vishay Dale IHLE电感器;Vishay Custom Magnetics TPL系列混合平面变压器;以及Vishay Siliconix microBUCK®和microBRICKÔ功率IC。
APEC是应用电力电子领域的重要活动,重点展示电力电子企业产品的实际应用。欲了解展会更多信息,请访问 http://www.apec-conf.org/ 。
MOSFET与三极管的ON状态区别
demi 在 提交

意法半导体推出MDmesh™系列600V超结晶体管,该产品针对提高中等功率谐振软开关和硬开关转换器拓扑能效而设计。
针对软开关技术优化的阈值电压使新型晶体管非常适用于节能应用中的LLC谐振转换器和升压PFC转换器。电容电压曲线有助于提高轻载能效,最低16 nC的栅极电荷量(Qg)可实现高开关频率,这两个优点让MDmesh M6器件在硬开关拓扑结构中也有良好的能效表现。
此外,意法半导体最先进的M6超结技术将RDS(ON)电阻降至0.036Ω,有助于电池充电器、电源适配器、PC电源、LED照明驱动器、电信设备和服务器电源以及太阳能微型逆变器等设备进一步提高能效和功率密度。
封装选择包括节省空间和热效率高的新型无引线TO-LL封装,以及流行的通孔封装和贴装封装,包括DPAK、D2PAK、TO-220、TO-247和PowerFLAT™。 JEDEC注册的TO-LL功率封装比现有的7引脚D²PAK封装,面积小30%,厚度薄50%,可实现尺寸更紧凑、空间利用率更高的电源转换器。TO-LL的低寄生电感还有助于最大限度地减少电磁干扰。
MDmesh M6系列属于STPOWER™产品组合,包含37款产品,覆盖13A至72A的额定电流范围。MDmesh M6现已投产。有关产品售价和样片申请,请联系所在地意法半导体销售代表处。
详情访问 www.st.com/stpower 。
1、由于MOSFET的结构,通常它可以做到电流很大,可以到上KA,但耐压能力没有IGBT强。
2、IGBT可以做很大功率,电流和电压都可以,就是一点频率不是太高,目前IGBT硬开关速度可以到100KHZ,那已经是不错了。不过相对于MOSFET的工作频率还是九牛一毛,MOSFET可以工作到几百KHZ,上MHZ,以至几十MHZ。
3、就其应用:根据其特点MOSFET应用于开关电源,镇流器,高频感应加热;高频逆变焊机;通信电源等等高频电源领域;IGBT集中应用于焊机,逆变器,变频器,电镀电解电源,超音频感应加热等领域。
开关电源(SMPS) 的性能在很大程度上依赖于功率半导体器件的选择,即开关管和整流器。
虽然没有万全的方案来解决选择IGBT还是MOSFET的问题,但针对特定SMPS应用中的IGBT 和MOSFET进行性能比较,确定关键参数的范围还是能起到一定的参考作用。
本文将对一些参数进行探讨,如硬开关和软开关ZVS(零电压转换) 拓扑中的开关损耗,并对电路和器件特性相关的三个主要功率开关损耗—导通损耗、传导损耗和关断损耗进行描述。此外,还通过举例说明二极管的恢复特性是决定MOSFET 或 IGBT导通开关损耗的主要因素,讨论二极管恢复性能对于硬开关拓扑的影响。
导通损耗
除了IGBT的电压下降时间较长外,IGBT和功率MOSFET的导通特性十分类似。由基本的IGBT等效电路(见图1)可看出,完全调节PNP BJT集电极基极区的少数载流子所需的时间导致了导通电压拖尾出现。

这种延迟引起了类饱和效应,使集电极/发射极电压不能立即下降到其VCE(sat)值。这种效应也导致了在ZVS情况下,在负载电流从组合封装的反向并联二极管转换到IGBT的集电极的瞬间,VCE电压会上升。IGBT产品规格书中列出的Eon能耗是每一转换周期Icollector与VCE乘积的时间积分,单位为焦耳,包含了与类饱和相关的其他损耗。其又分为两个Eon能量参数,Eon1和Eon2。Eon1是没有包括与硬开关二极管恢复损耗相关能耗的功率损耗;Eon2则包括了与二极管恢复相关的硬开关导通能耗,可通过恢复与IGBT组合封装的二极管相同的二极管来测量,典型的Eon2测试电路如图2所示。IGBT通过两个脉冲进行开关转换来测量Eon。第一个脉冲将增大电感电流以达致所需的测试电流,然后第二个脉冲会测量测试电流在二极管上恢复的Eon损耗。
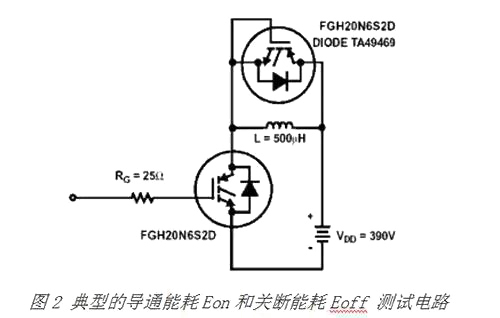
在硬开关导通的情况下,栅极驱动电压和阻抗以及整流二极管的恢复特性决定了Eon开关损耗。对于像传统CCM升压PFC电路来说,升压二极管恢复特性在Eon (导通) 能耗的控制中极为重要。除了选择具有最小Trr和QRR的升压二极管之外,确保该二极管拥有软恢复特性也非常重要。软化度,即tb/ta比率,对开关器件产生的电气噪声和电压尖脉冲有相当的影响。某些高速二极管在时间tb内,从IRM(REC)开始的电流下降速率(di/dt)很高,故会在电路寄生电感中产生高电压尖脉冲。这些电压尖脉冲会引起电磁干扰(EMI),并可能在二极管上导致过高的反向电压。
在硬开关电路中,如全桥和半桥拓扑中,与IGBT组合封装的是快恢复管或MOSFET体二极管,当对应的开关管导通时二极管有电流经过,因而二极管的恢复特性决定了Eon损耗。所以,选择具有快速体二极管恢复特性的MOSFET十分重要。不幸的是,MOSFET的寄生二极管或体二极管的恢复特性比业界目前使用的分立二极管要缓慢。因此,对于硬开关MOSFET应用而言,体二极管常常是决定SMPS工作频率的限制因素。
一般来说,IGBT组合封装二极管的选择要与其应用匹配,具有较低正向传导损耗的较慢型超快二极管与较慢的低VCE(sat)电机驱动IGBT组合封装在一起。相反地,软恢复超快二极管,可与高频SMPS2开关模式IGBT组合封装在一起。
除了选择正确的二极管外,设计人员还能够通过调节栅极驱动导通源阻抗来控制Eon损耗。降低驱动源阻抗将提高IGBT或MOSFET的导通di/dt及减小Eon损耗。Eon损耗和EMI需要折中,因为较高的di/dt会导致电压尖脉冲、辐射和传导EMI增加。为选择正确的栅极驱动阻抗以满足导通di/dt 的需求,可能需要进行电路内部测试与验证,然后根据MOSFET转换曲线可以确定大概的值 (见图3)。
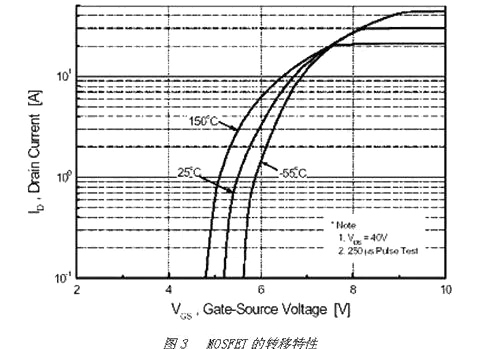
假定在导通时,FET电流上升到10A,根据图3中25℃的那条曲线,为了达到10A的值,栅极电压必须从5.2V转换到6.7V,平均GFS为10A/(6.7V-5.2V)=6.7mΩ。

把平均GFS值运用到公式1中,得到栅极驱动电压Vdrive=10V,所需的 di/dt=600A/μs,FCP11N60典型值VGS(avg)=6V,Ciss=1200pF;于是可以计算出导通栅极驱动阻抗为37Ω。由于在图3的曲线中瞬态GFS值是一条斜线,会在Eon期间出现变化,意味着di/dt也会变化。呈指数衰减的栅极驱动电流Vdrive和下降的Ciss作为VGS的函数也进入了该公式,表现具有令人惊讶的线性电流上升的总体效应。
同样的,IGBT也可以进行类似的栅极驱动导通阻抗计算,VGE(avg) 和GFS可以通过IGBT的转换特性曲线来确定,并应用VGE(avg)下的CIES值代替Ciss。计算所得的IGBT导通栅极驱动阻抗为100Ω,该值比前面的37Ω高,表明IGBT GFS较高,而CIES较低。这里的关键之处在于,为了从MOSFET转换到IGBT,必须对栅极驱动电路进行调节。
传导损耗需谨慎
在比较额定值为600V的器件时,IGBT的传导损耗一般比相同芯片大小的600 V MOSFET少。这种比较应该是在集电极和漏极电流密度可明显感测,并在指明最差情况下的工作结温下进行的。例如,FGP20N6S2 SMPS2 IGBT 和 FCP11N60 SuperFET均具有1℃/W的RθJC值。图4显示了在125℃的结温下传导损耗与直流电流的关系,图中曲线表明在直流电流大于2.92A后,MOSFET的传导损耗更大。
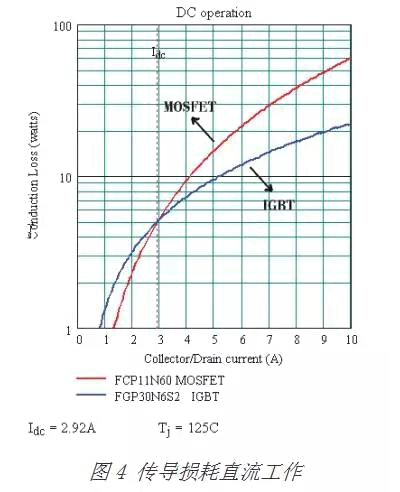

不过,图4中的直流传导损耗比较不适用于大部分应用。同时,图5中显示了传导损耗在CCM (连续电流模式)、升压PFC电路,125℃的结温以及85V的交流输入电压Vac和400 Vdc直流输出电压的工作模式下的比较曲线。图中,MOSFET-IGBT的曲线相交点为2.65A RMS。对PFC电路而言,当交流输入电流大于2.65A RMS时,MOSFET具有较大的传导损耗。2.65A PFC交流输入电流等于MOSFET中由公式2计算所得的2.29A RMS。MOSFET传导损耗、I2R,利用公式2定义的电流和MOSFET 125℃的RDS(on)可以计算得出。把RDS(on)随漏极电流变化的因素考虑在内,该传导损耗还可以进一步精确化,这种关系如图6所示。
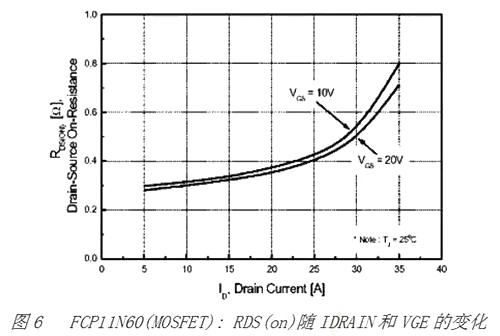
一篇名为“如何将功率MOSFET的RDS(on)对漏极电流瞬态值的依赖性包含到高频三相PWM逆变器的传导损耗计算中”的IEEE文章描述了如何确定漏极电流对传导损耗的影响。作为ID之函数,RDS(on)变化对大多数SMPS拓扑的影响很小。例如,在PFC电路中,当FCP11N60 MOSFET的峰值电流ID为11A——两倍于5.5A (规格书中RDS(on) 的测试条件) 时,RDS(on)的有效值和传导损耗会增加5%。
在MOSFET传导极小占空比的高脉冲电流拓扑结构中,应该考虑图6所示的特性。如果FCP11N60 MOSFET工作在一个电路中,其漏极电流为占空比7.5%的20A脉冲 (即5.5A RMS),则有效的RDS(on)将比5.5A(规格书中的测试电流)时的0.32欧姆大25%。

式2中,Iacrms是PFC电路RMS输入电流;Vac是PFC电路RMS输入电压;Vout是直流输出电压。
在实际应用中,计算IGBT在类似PFC电路中的传导损耗将更加复杂,因为每个开关周期都在不同的IC上进行。IGBT的VCE(sat)不能由一个阻抗表示,比较简单直接的方法是将其表示为阻抗RFCE串联一个固定VFCE电压,VCE(ICE)=ICE×RFCE+VFCE。于是,传导损耗便可以计算为平均集电极电流与VFCE的乘积,加上RMS集电极电流的平方,再乘以阻抗RFCE。
图5中的示例仅考虑了CCM PFC电路的传导损耗,即假定设计目标在维持最差情况下的传导损耗小于15W。以FCP11N60 MOSFET为例,该电路被限制在5.8A,而FGP20N6S2 IGBT可以在9.8A的交流输入电流下工作。它可以传导超过MOSFET 70% 的功率。
虽然IGBT的传导损耗较小,但大多数600V IGBT都是PT (穿透) 型器件。PT器件具有NTC (负温度系数)特性,不能并联分流。或许,这些器件可以通过匹配器件VCE(sat)、VGE(TH) (栅射阈值电压) 及机械封装以有限的成效进行并联,以使得IGBT芯片们的温度可以保持一致的变化。相反地,MOSFET具有PTC (正温度系数),可以提供良好的电流分流。
关断损耗 —问题尚未结束
在硬开关、钳位感性电路中,MOSFET的关断损耗比IGBT低得多,原因在于IGBT 的拖尾电流,这与清除图1中PNP BJT的少数载流子有关。图7显示了集电极电流ICE和结温Tj的函数Eoff,其曲线在大多数IGBT数据表中都有提供。 这些曲线基于钳位感性电路且测试电压相同,并包含拖尾电流能量损耗。
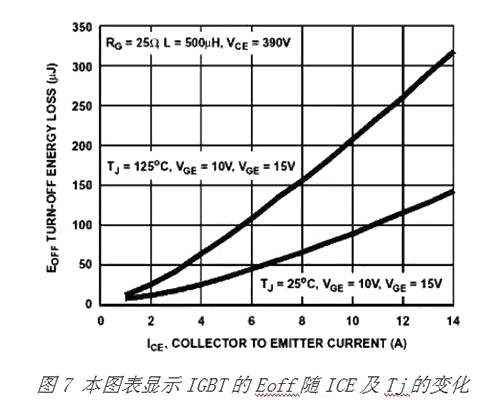
图2显示了用于测量IGBT Eoff的典型测试电路, 它的测试电压,即图2中的VDD,因不同制造商及个别器件的BVCES而异。在比较器件时应考虑这测试条件中的VDD,因为在较低的VDD钳位电压下进行测试和工作将导致Eoff能耗降低。
降低栅极驱动关断阻抗对减小IGBT Eoff损耗影响极微。如图1所示,当等效的多数载流子MOSFET关断时,在IGBT少数载流子BJT中仍存在存储时间延迟td(off)I。不过,降低Eoff驱动阻抗将会减少米勒电容CRES和关断VCE的dv/dt造成的电流注到栅极驱动回路中的风险,避免使器件重新偏置为传导状态,从而导致多个产生Eoff的开关动作。
ZVS和ZCS拓扑在降低MOSFET和IGBT的关断损耗方面很有优势。不过ZVS的工作优点在IGBT中没有那么大,因为当集电极电压上升到允许多余存储电荷进行耗散的电势值时,会引发拖尾冲击电流Eoff。ZCS拓扑可以提升最大的IGBT Eoff性能。正确的栅极驱动顺序可使IGBT栅极信号在第二个集电极电流过零点以前不被清除,从而显著降低IGBT ZCS Eoff 。
MOSFET的Eoff能耗是其米勒电容Crss、栅极驱动速度、栅极驱动关断源阻抗及源极功率电路路径中寄生电感的函数。该电路寄生电感Lx (如图8所示) 产生一个电势,通过限制电流速度下降而增加关断损耗。在关断时,电流下降速度di/dt由Lx和VGS(th)决定。如果Lx=5nH,VGS(th)=4V,则最大电流下降速度为VGS(th)/Lx=800A/μs。

总结
在选用功率开关器件时,并没有万全的解决方案,电路拓扑、工作频率、环境温度和物理尺寸,所有这些约束都会在做出最佳选择时起着作用。
在具有最小Eon损耗的ZVS 和 ZCS应用中,MOSFET由于具有较快的开关速度和较少的关断损耗,因此能够在较高频率下工作。
对硬开关应用而言,MOSFET寄生二极管的恢复特性可能是个缺点。相反,由于IGBT组合封装内的二极管与特定应用匹配,极佳的软恢复二极管可与更高速的SMPS器件相配合。
后语
MOSFE和IGBT是没有本质区别的,人们常问的“是MOSFET好还是IGBT好”这个问题本身就是错误的。至于我们为何有时用MOSFET,有时又不用MOSFET而采用IGBT,不能简单的用好和坏来区分,来判定,需要用辩证的方法来考虑这个问题。
转自:玩转单片机








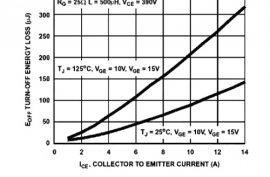

支持电动和混合动力汽车、数据中心和辅助电源等高频、高效电源控制应用
10月22日,Littelfuse公司宣布推出其首款1700V碳化硅MOSFET LSIC1MO170E1000,扩充了其碳化硅MOSFET器件组合。 LSIC1MO170E1000既是Littelfuse碳化硅MOSFET产品的重要补充,也是Littelfuse公司已发布的1200V碳化硅MOSFET和肖特基二极管的强有力补充。最终用户将受益于更加紧凑节能的系统以及潜在更低的总体拥有成本。
碳化硅MOSFET技术带来的高效性可为诸多要求严格的应用提供多重优势,包括电动和混动汽车、数据中心及辅助电源。 相比同类的Si IGBT,LSIC1MO170E1000碳化硅MOSFET可带来一系列系统级优化机会,包括提高效率、增加功率密度、降低冷却要求以及降低系统级成本的可能性。
此外,相比市面上其他业内领先的碳化硅MOSFET器件,Littelfuse碳化硅MOSFET可在各方面提供同等或更优越的性能。
碳化硅MOSFET LSIC1MO170E1000的典型应用包括:
• 太阳能逆变器
• 开关模式和不间断电源
• 电机驱动器
• 高压DC/DC转换器
• 感应加热
“此产品可改善现有应用,并且Littelfuse应用支持网络可促进新的设计方案。”Littelfuse半导体事业部电源半导体全球产品营销经理Michael Ketterer表示。 “碳化硅MOSFET可为基于硅的传统功率晶体管器件提供富有价值的替代选择。 相比同类IGBT,MOSFET器件结构可减少每个周期的开关损耗并提高轻载效率。 固有的材料特性让碳化硅MOSFET能够在阻断电压、特定导通电阻和结电容方面优于硅MOSFET。”
新推出的1700V、1 Ohm碳化硅MOSFET采用TO-247-3L封装,具有以下关键优势:
• 专为高频、高效应用优化
• 极低栅极电荷和输出电容
• 低栅极电阻,适用于高频开关
供货情况
LSIC1MO170E1000碳化硅MOSFET采用450只装TO-247-3L管式封装。 您可通过全球各地的Littelfuse授权经销商索取样品。 如需了解Littelfuse授权经销商名录,请访问littelfuse.com。
如要了解更多信息:
可通过以下方式查看更多信息:LSIC1MO170E1000E碳化硅MOSFET产品页面。
如要了解供应情况、初始定价和一般技术咨询,请联系Littelfuse半导体事业部电源半导体全球产品营销经理Michael Ketterer: mketterer@littelfuse.com。
如有技术问题,请联系:电源半导体热线: powersemisupport@littelfuse.com.
新器件进一步提高电源效率
东芝电子元件及存储装置株式会社(“东芝”)推出新系列的下一代650V功率MOSFET,用于数据中心服务器电源、太阳能(PV)功率调节器、不间断电源系统(UPS)和其他工业应用。
TK040N65Z是DTMOS VI系列的首款器件,是一款支持高达57A连续漏极电流(ID)的650V器件,而出现脉冲电流(IDP)时,可支持高达228A的连续漏极电流。该款新器件提供0.04Ω(0.033Ω典型值)超低漏源极导通电阻RDS(ON),可有效减少电源应用中的损耗。得益于更低的电容设计,该款增强型器件成为现代高速电源应用的理想之选。
关键性能指标/品质因数(FoM) – RDS(ON) x Qgd的降低使得电源效率得到提高。与上一代DTMOS IV-H器件相比,TK040N65Z的这一重要指标提升40%,这意味着电源效率显著提高,据测量,2.5kW PFC电路中电源效率提高大约0.36%[1]。
该款新器件采用业界标准的TO-247封装,既实现了与旧版设计的兼容性,也适用于新项目。
为满足市场需求,东芝将继续扩大其产品阵容并帮助提高电源和电源系统的效率。
该款新器件的批量生产和出货即日启动。
应用场合
• 数据中心(服务器电源等)
• 光伏发电机功率调节器
• 不间断电源系统
特点
• RDS(ON) × Qgd降低,支持开关电源提高效率
|
主要规格 |
|||||||||
|
(@Ta=25oC) |
|||||||||
|
产品型号 |
封装 |
绝对最大额定值 |
漏源极导通电阻 RDS(ON)最大值 @VGS=10 V (Ω) |
总栅极电荷 Qg典型值 (nC) |
栅漏电荷 Qgd 典型值 (nC) |
输入电容 Ciss 典型值 (pF) |
上一代系列 (DTMOS IV-H) 产品 型号 |
库存查询与购买 |
|
|
漏源极电压 VDSS(V) |
漏极电流(直流) ID(A) |
||||||||
|
TO-247 |
650 |
57 |
0.040 |
105 |
27 |
6250 |
TK62N60X |
||
注:
[1] 截至2018年6月,东芝测量值(2.5kW PFC电路@输出功率=2.5kW)。
有关东芝400-900V MOSFET产品阵容的更多信息,请访问以下链接:
https://toshiba.semicon-storage.com/ap-en/product/mosfet/hv-mosfet.html
请访问以下链接,查看线上分销商处的新产品供应信息:
https://toshiba.semicon-storage.com/ap-en/buy/stockcheck.TK040N65Z.html



