
9、为什么在E-MOSFET的栅-漏转移特性上,随着栅-源电压的增大,首先出现的是饱和区电流、然后才是线性区电流?
【答】E-MOSFET的栅-漏转移特性如图1所示。在栅-源电压VGS小于阈值电压VT时,器件截止(没有沟道),源-漏电流电流很小(称为亚阈电流)。
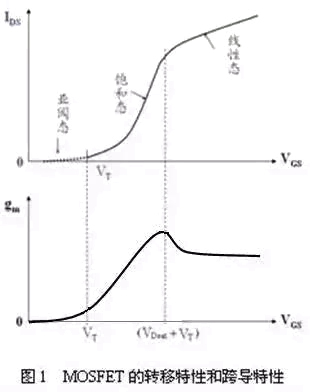
在VGS>VT时,出现沟道,但如果源-漏电压VDS=0,则不会产生电流;只有在VGS>VT和VDS>0时,才会产生电流,这时必然有VDS >(VGS-VT),因此MOSFET处于沟道夹断的饱和状态,于是源-漏电流随栅-源电压而平方地上升。相应地,饱和跨导随栅-源电压而线性地增大,这是由于饱和跨导与饱和电压(VGS-VT)成正比的缘故。
而当栅-源电压进一步增大,使得VDS<(VGS-VT)时,则MOSFET又将转变为沟道未夹断的线性工作状态,于是源-漏电流随栅-源电压而线性地增大。这时,跨导不再变化(与栅电压无关)。
10、为什么MOSFET的电流放大系数截止频率fT与跨导gm成正比?
【答】MOSFET的fT就是输出电流随着频率的升高而下降到等于输入电流时的频率。器件的跨导gm越大,输出的电流就越大,则输出电流随频率的下降也就越慢,从而截止频率就越大,即fT与gm有正比关系:

由于fT与gm的正比关系,就使得fT与饱和电压(VGS-VT)也有正比关系,从而高频率就要求较大的饱和电压。
11、为什么提高MOSFET的频率与提高增益之间存在着矛盾?
【答】MOSFET的高频率要求它具有较大的跨导,而在源-漏电压一定的情况下,较大的跨导又要求它具有较大的饱和电压(VGS-VT),所以高频率也就要求有较大的饱和电压。
因为MOSFET的电压增益是在源-漏电流一定的情况下、输出电压VDS对栅-源电压VGS的微分,则饱和状态的电压增益Kvsat将要求器件具有较小的饱和电压(VGS-VT):

这是由于在IDsat一定时,饱和电压越低,饱和跨导就越大,故Kvsat也就越大。
可见,提高频率与增大电压增益,在对于器件饱和电压的要求上存在着矛盾。因此,在工作电流IDsat一定时,为了提高电压增益,就应该减小(VGS-VT)和增大沟道长度L。这种考虑对于高增益MOSFET具有重要的意义;但是这种减小(VGS-VT)的考虑却对于提高截止频率不利。
12、为什么E-MOSFET的栅-源短接而构成的MOS二极管存在着“阈值损失”?
【答】这种集成MOS二极管的连接方式及其伏安特性如图2所示。因为栅极与漏极短接,则VGS=VDS。因此,当电压较小(VGS=VDS<VT)时,不会出现沟道,则器件处于截止状态,输出电流IDS=0;当电压高于阈值电压(VGS=VDS≥VT)时,因为总满足VDS>(VGS-VT)关系,于是出现了沟道、但总是被夹断的,所以器件处于饱和状态,输出源-漏电流最大、并且饱和,为恒流源。
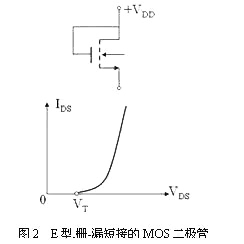
由于VGS=VDS,所以这种二极管的输出伏安特性将与转移特性完全一致。因为MOSFET的饱和输出电流IDsat与饱和电压(VGS-VT)之间有平方关系,所以该二极管在VGS=VDS≥VT时的输出伏安特性为抛物线关系,并且这也就是其转移特性的关系。
所谓阈值损失,例如在门电路中,是输出高电平要比电源电压低一个阈值电压大小的一种现象。由E型,栅-漏短接的MOS二极管的伏安特性可以见到,当其输出源-漏电流IDS降低到0时,其源-漏电压VDS也相应地降低到VT。这就意味着,这种二极管的输出电压最低只能下降到VT,而不能降低到0。这种“有电压、而没有电流”的性质,对于用作为有源负载的这种集成MOS二极管而言,就必将会造成阈值损失。
13、为什么在MOSFET中存在有BJT的作用?这种作用有何危害?
【答】①对于常规的MOSFET:如图3(a)所示,源区、漏区和p衬底即构成了一个npn寄生晶体管。当沟道中的电场较强时,在夹断区附近的电子即将获得很大的能量而成为热电子,然后这些热电子通过与价电子的碰撞、电离,就会形成一股流向衬底的空穴电流Ib;该过衬底电流就是寄生晶体管的基极电流,在热电子效应较严重、衬底电流较大时,即可使寄生晶体管导通,从而破坏了MOSFET的性能。这种热电子效应的不良影响往往是较短沟道MOSFET的一种重要失效机理。
②对于CMOS器件:在CMOS器件的芯片中,存在着npnp的四层结构——晶闸管。当其中的BJT因为热电子效应而导通时,即可发生所谓“闩锁效应”、而导致器件失效。

③对于VDMOSFET:观察图3(b)中的结构,即可见到,当器件正向导通时,其中存在一个工作于放大状态的寄生n-p-n晶体管(n+源区是发射区,n-外延层是集电区,p沟道是基区)。该寄生晶体管的可能导电通道是与MOSFET的ID相并联的,故在VDMOSFET工作时,必须要注意防止寄生晶体管导通;否则,寄生晶体管的导通就可能引起二次击穿,使得功率MOSFET完全失去功能。
为了避免VDMOSFET在正向工作时、其中寄生n-p-n晶体管的导通,可以设法使寄生晶体管的电流放大系数变得很小、甚至减至为0——采用“阴极短路技术”,即把寄生晶体管的发射极与基极短接起来,工艺上就通过把发射区(源极区)的金属电极延伸到沟道体区的表面上来实现。因为这种阴极短路结构截断了发射极注入载流子的功能,所以能够防止寄生晶体管的导通。
对于VDMOSFET,在采用了阴极短路结构之后,实际上又恰恰在器件内部形成了一个p-n-n+二极管,这个二极管与VDMOSFET是反向并联的,这也就顺便地在VDMOSFET中设置了一个阻尼二极管(续流二极管),该二极管对于泄放反向电动势、防止主体晶体管的击穿具有重要作用。
14、为什么在VDMOSFET中存在有JFET的作用?有何不良影响?
【答】如图4所示,源-漏电流是从芯片表面向下流动的,并在电流通路的两侧是pn结,因此这种电流输运的过程,从工作原理上来看,就相当于是一个寄生JFET。从而可以把VDMOSFET等效为一个MOSFET与一个寄生JFET的串联组合,其中很大部分n-漂移区就相当于是寄生JFET的沟道。
由于JFET的输出交流电阻非常大,同时也因为较高的源-漏电压而具有很大的输出直流电阻,所以就使得VDMOSFET的导通电阻大大增加,因此n-漂移区的厚度和掺杂浓度对整个器件性能的影响都较大。
为了消除VDMOSFET中寄生JFET的影响,以降低导通电阻,就必须在结构上加以改变,由此发展出了V形槽栅、U形槽栅和沟槽(Trench)栅等结构的MOSFET。
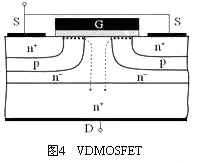
15、IGBT和MCT都是MOS栅极控制的功率场效应晶体管,为什么说它们是两种完全不同的器件?
【答】IGBT(绝缘栅双极型场效应晶体管)和MCT(MOS控制晶闸管)的共同点主要有:
①都是MOS栅极控制的器件,则具有功率场效应晶体管的优点;
②在结构上,其中都存在着四层、三结的晶闸管结构,因此在一定条件下会出现阳极电流闩锁效应;
③它们都可以采用多个元胞并联的结构,因此可以获得很大的工作电流;
④它们都是有两种载流子参与工作的器件,因此都是双极型的场效应晶体管,导通电阻低,但开关速度也相对地要比MOSFET的低。
IGBT和MCT的最大不同点就在于它们的工作状态和性质不相同,因此说它们是两种完全不同的器件:
①IGBT的工作电流主要是通过MOS沟道的电流,而其中的晶闸管电流是需要极力避免的(IGBT的最大工作电流——擎住电流就是其中晶闸管不导通时的电流),因此从本质上来看,IGBT基本上是一种MOSFET,因此IGBT具有MOS器件的许多优点,例如较强的栅极的控制能力和较低的驱动功率(因为有很大的输入电阻和较小的输入电容之故)。
而MCT与IGBT的恰恰相反,它的工作电流主要是晶闸管电流,至于MOS沟道的电流,则主要是起着触发晶闸管导通或者关断的作用,不是MCT的主要工作电流,因此从本质上来看,MCT基本上是一种晶闸管——双极型器件,从而MCT具有导通电阻很低、耐压很高、功率容量很大的优点。
②IGBT虽然在本质上是一种MOS器件,但又不同于一般的MOSFET,因为IGBT在导通工作时,有少数载流子注入到高阻的耐压层(漂移区),可以产生电导调制,则它的导通电阻较小,增大了器件的电流容量(电流密度要比VDMOSFET的高2~3倍);同时由于高阻耐压层的引入而提高了工作电压。因此IGBT的功率容量很大。只是IGBT的开关速度,由于少数载流子的引入而相应地有所降低。
③虽然MCT本质上是一种晶闸管,而且MOS栅极可以关断阳极电流,但MCT又不同于一般的可关断晶闸管(GTO)。因为MCT实际上是一种把单极型的MOSFET与双极型的晶闸管组合而成的复合型器件,也是一种所谓Bi-MOS器件,所以它具有MOS器件和双极型器件二者的长处:较强的栅极控制能力,较低的驱动功率,较高的开关速度,较大功率容量。
本文转载自:网络


